[테크다이브] SK하이닉스가 '메모리 한계' 뛰어넘는 법
- 가
- 가

[디지털데일리 김도현 기자] 지난 5일 서울 강남구 코엑스에서 ‘반도체대전(SEDEX) 2022’가 개막했습니다. 산업통상자원부가 주최하고 한국반도체산업협회(KSIA)가 주관하는 이 행사는 국내 최대 반도체 전시회로 꼽힙니다.
이날 곽 사장은 ‘메모리 기술의 한계를 넘어서’라는 주제로 발표했습니다. 1994년 현대전자(SK하이닉스 전신)로 입사해 약 30년 동안 ‘하이닉스맨’으로 살아온 내공을 그대로 보여줬습니다.
그에 따르면 2010년 스마트폰 시대 개화, 2020년 5세대(G) 이동통신 도입 및 클라우드 시장 성장 등으로 데이터 사용량이 빠르게 증가하고 있습니다. 이에 걸맞은 D램과 낸드플래시 성능 개선이 요구되는데요. 현재 방식으로는 물리적인 제약이 불가피하다는 분석이 나옵니다. 삼성전자와 SK하이닉스, 마이크론 등은 이를 극복하기 위해 새로운 혁신을 준비 중이죠.
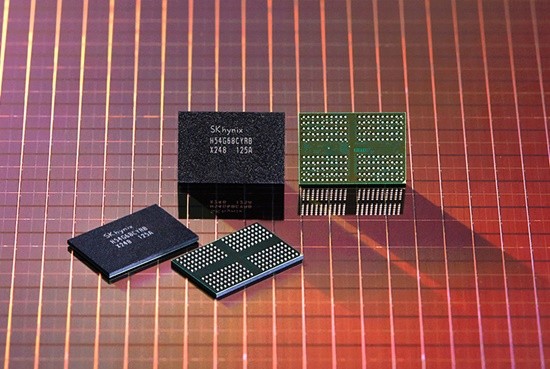
SK하이닉스 '1a D램'
차세대 제품으로 5세대(1b), 6세대(1c)가 나올 예정인데 1b는 12nm대, 1c는 11nm대로 추정됩니다. 다음은 10nm대인 7세대(1d)일 텐데 1d부터 D램 업계가 난항을 겪을 것으로 예상됩니다.
곽 사장은 “1d D램 정도 되면 또 다른 벽이 생기게 된다. 핀과 핀 사이가 너무 가까워져 트랜지스터 동작이 어려워진다”며 “커패시터, D램 면적도 50% 이하로 감소하면서 큰 저항이 올 것”이라고 말했습니다.
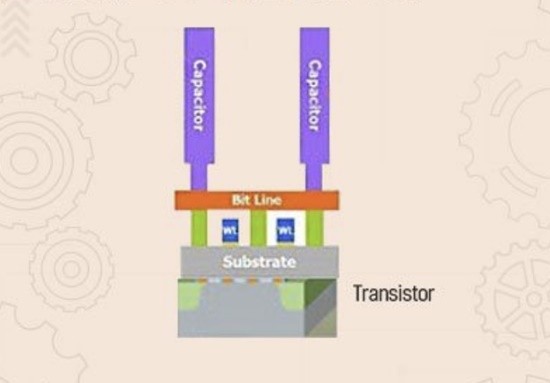
셀은 하나의 트랜지스터와 하나의 커패시터로 구성되죠. 각각 데이터를 제어하고 저장하는 역할을 담당합니다. 트랜지스터는 다시 스위치인 워드라인과 전하(데이터)가 흘러 다니는 비트라인으로 이뤄집니다. 간단히 정리하면 한 쌍의 트랜지스터와 커패시터가 0 또는 1을 저장하고 빼내면서 동작하는 게 D램입니다.

이 과정에서 메모리 제조사는 D램 공정에 극자외선(EUV) 노광 기술을 도입하는 묘수를 둡니다. EUV는 기존 불화아르곤(ArF) 대비 13~14배 짧은 파장을 통해 미세 패턴을 새길 수 있는 방식입니다. 얇은 붓을 쓰면 세밀한 그림을 그릴 수 있고 야구방망이를 짧게 잡으면 정교한 타격이 가능해지는 것과 같은 원리죠. 삼성전자와 SK하이닉스는 1a D램부터 EUV를 본격 활용 중인데 1d D램부터는 다른 방법이 필요할 것으로 보입니다.
곽 사장은 “패터닝과 정전 용량 극복을 위해 각각 하이NA 도입, 새로운 하이-K가 필요하다”면서도 “이러한 스케일 다운만으로는 한계가 있다. 3차원(3D) D램이라 부르는 스태킹 기술이 대안으로 꼽힌다”고 설명했습니다. 하이NA는 기존 EUV를 개선한 버전, 하이-K는 커패시터를 만들 때 사용하는 물질인데요. 두 용어에 대해서는 다음에 따로 다뤄볼게요.

셀을 눕힌 채 적층하는 기술, 셀을 눕히지 않고 트랜지스터와 커패시터 모양을 변형하는 방식, 트랜지스터의 게이트(전류 대문)와 채널(전류 통로)이 닿는 면을 늘리는 방안 등이 대상이죠. 3번째의 경우 시스템반도체에서 활용되는 핀펫(FinFET) 또는 게이트올어라운드(GAA)를 의미합니다. 각각 3면, 4면이 닿는 구조인데 접촉면이 많을수록 정밀한 제어를 할 수 있죠.
곽 사장은 “3D D램은 기존 문제를 해결하는 동시에 새로운 문제를 만들기도 한다. 전하 이동이 충분치 않고, 스루풋(단위 시간 내 데이터 처리능력)이 낮고, 생산 비용 급증 등이 난제”라며 “플랫폼이 달라진 만큼 다른 관리 포인트가 필요해지는 것이다. 빨리 시작해서 이슈를 해소하고 개발하는 게 중요하다”고 강조했습니다. 3D D램이 상용화되기 위해서는 신소재 발굴, 물리적 장애물 극복 등이 우선 과제로 꼽힙니다.
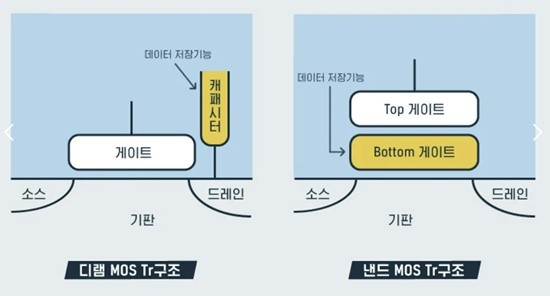
일단 낸드 구조를 파악해야 할 것 같은데요. 낸드 역시 셀을 기반으로 구성되는데 D램과 달리 커패시터가 없습니다. 대신 D램 트랜지스터 게이트가 1개라면 낸드 트랜지스터 게이트 2개입니다. 상판 게이트(컨트롤 게이트)와 하판 게이트(플로팅 게이트)로 나뉘는데요. 각각 전압을 걸고, 전하(데이터)를 저장하는 역할을 합니다. 여기서 중요한 게 후자인데 전기가 통하지 않는 절연체 막을 둘러싸여 있어 전하를 붙잡아 둘 수 있는 거죠. 이 때문에 전원이 꺼지더라도 정보가 저장되는 낸드 특성이 발휘될 수 있답니다.
낸드에서는 셀을 방으로 생각하면 쉽습니다. 방을 1명이 쓰냐, 2명이 쓰냐, 3명이 쓰냐에 따라 SLC(Single level cell), MLC(Multi), TLC(Triple) 등으로 구분되죠. 하나의 셀은 1b고 0과 1을 사용할 수 있는데 이게 SLC죠. MLC에서는 셀이 2개(2b)니까 00, 01, 10, 11 등을 다룰 수 있고요. TLC는 000, 001, 010, 011, 100, 101, 110, 111 등 8개가 가능하죠. 2의 배수로 가는 규칙입니다.
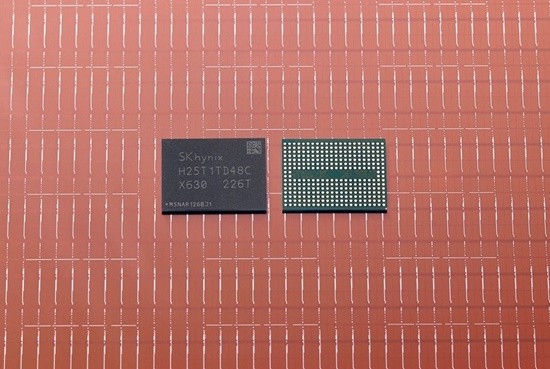
SK하이닉스 '238단 TLC 4D 낸드'
이날 곽 사장은 QLC를 넘어 PLC(Penta)를 언급했는데요. 그는 “낸드 적층의 목적은 단위 면적당 비트 수를 늘리는 것”이라며 ““TLC가 양산 중이고 QLC는 샘플이 나오는 단계다. 다음으로 PLC로 가는 기술이 필요하다”고 전했습니다.
일각에서는 QLC 또는 PLC로 가면 낸드 수명이 대폭 줄어들 것으로 우려하는데요. 구성원이 많아지면 갈등이 잦을 가능성이 크기 때문이죠. 이에 곽 사장은 ▲고속 트랜지스터를 통한 낸드 고속화 ▲전도성을 낮추기 위한 웨이퍼 본딩 기술 적용 등을 대안으로 꼽았습니다.
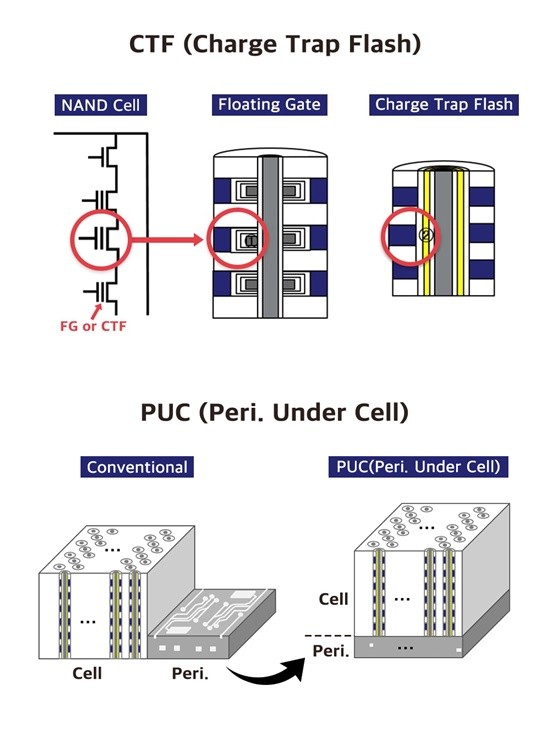
낸드가 2D에서 3D로 전환하면서 전하를 부도체에 저장하는 CTF(Charged Trap Flash) 방식이 적용됐어요. 2D 낸드는 전하를 도체에 저장했었는데 CTF를 통해 셀 간 간섭 문제를 해결한 것이죠. 단위 셀 면적도 줄이고 읽기, 쓰기 성능도 높일 수 있다고 하네요.
SK하이닉스는 한발 더 나아가 CTF에 PUC(Peripheral Under Cell)라는 기술을 결합합니다. 이를 4D 낸드라 부르는데요, PUC는 셀 영역 하부에 셀 작동을 관장하는 주변부 회로를 배치하는 방식입니다. 2D 및 3D 낸드는 셀 영역 옆에 주변부 회로를 배치했다면, 4D는 하단부로 옮겨 효율을 극대화한 것이죠. 공간 활용도와 생산성이 동시에 올라간 덕분입니다.

곽 사장은 “2D에서 3D로 변경하면 당시 낸드 이슈를 극복했으나 400단, 500단 등으로 계속 높아질 수 있는지가 관건”이라며 “낸드는 가급적 단수는 쌓되 물리적 높이는 낮추도록 노력해야 한다. 문제는 층 두께가 얇아지면 물리적 한계에 도달하는 점”이라고 분석했습니다.
아울러 100단대 후반 들어 낸드 1위인 삼성전자마저 두 번에 나눠 쌓는 더블스택 방식을 도입 중인데요. 더 높아질수록 3, 4번으로 세분화될 수 있겠죠. 곽 사장은 이에 따라 시간과 비용 증가도 해결 과제라고 지적했어요. 낸드 제조 과정 시 새기는 패턴을 최소화해서 사용 면적을 줄이는 대안도 소개했죠.

PIM(Processing In Memory)가 대표적입니다. 곽 사장은 “CPU 또는 그래픽처리장치(GPU)에서 메모리로 데이터가 왔다갔다 하면 상대적으로 느려진다. 간단한 연산은 메모리에서 하고 꼭 필요한 것만 CPU 쪽으로 넘기면 병목현상을 줄일 수 있다”고 말했습니다.

30분이라는 짧다면 짧고 길다면 긴 시간 동안 우리나라 반도체 대장이자 SK하이닉스 사장의 강연을 들어볼 수 있었는데요. 엔지니어 출신답게 차세대 기술에 대한 많은 고민이 느껴졌습니다. 그만큼 메모리 선두권을 유지하기 위한 노력을 이어가고 있다는 뜻이기도 하겠죠. 다가올 기술적 한계를 국내 기업이 어떤 식으로 뛰어넘을지 기대가 됩니다.
Copyright ⓒ 디지털데일리. 무단전재 및 재배포 금지

당신이 좋아할 만한 뉴스
많이 본 기사
연재기사
실시간 추천 뉴스
- 2025-04-12 13:06:55
-
"국가안보에 심각한 위협" 주요 보안당국이 경고한 '패스트 플럭스'란?
2025-04-12 11:37:05 -
6백억 DIP 대출, MBK의 홈플러스 회생 전략 논란…채권단 변제 뒤로 밀릴수도
2025-04-11 21:52:40 -
카카오 김범수, 재판 불출석…"수술 회복중, 당분간 참석 어려워"
2025-04-11 18:13:14 -
하나생명- 하나금융티아이, 인천 영종도 해안 플로깅 사회공헌활동
2025-04-11 17:32:03

























