삼성 팬아웃 TSMC 특허 회피가 관건…정부 지원 필요성↑
- 가
- 가
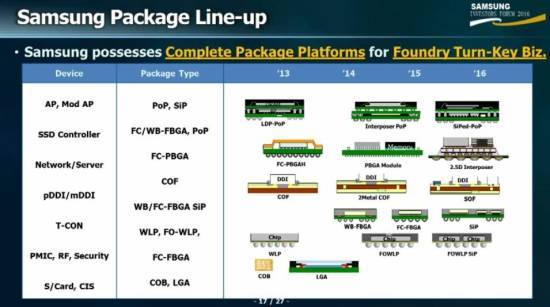
대만 위탁생산(TSMC) 업체 TSMC가 ‘팬아웃웨이퍼레벨패키지(Fan Out Wafer Level Package, FOWLP)’를 앞세워 애플의 애플리케이션프로세서(AP) 물량을 전량 확보한 가운데 삼성전자도 삼성전기와 함께 기술 확보에 박차를 가하고 있다. 빛을 이용해 회로를 그리는 노광 공정의 한계를 극복하기 위한 방안으로 본격적인 후공정 시대가 열리고 있는 것.
하지만 인피니언, 퀄컴(NXP·프리스케일), 에픽테크놀로지, TSMC 등이 원천특허를 보유하고 있어 이를 회피할 수 있는 연구개발(R&D)과 정부 차원에서의 지원 방안이 필요할 것으로 보인다.
“FOWLP에서 에픽테크놀로지의 특허를 피하기가 쉽지 않으며 상대적으로 기술개발이 늦어진 우리나라 입장에서 정부 지원이 필요할 것” 11일 한국전자통신연구원 최광성 박사는 특허청과 차세대반도체연구회 주최로 열린 ‘2016 차세대 반도체 지식재산권 포럼’에서 기자와 만나 이같이 밝혔다.
노광과 같은 전공정 기술 한계는 패키징으로 대표되는 후공정을 가속화하는 계기가 됐다. 그동안 반도체 산업을 이끈 ‘무어의 법칙’을 대신할 ‘모어 댄 무어(More than Moore)’가 대두되고 있는 상황. FOWLP는 같은 면적에서 더 높은 성능의 반도체를 구현할 수 있는 기술로 입출력(I/O) 배선을 칩 밖으로 빼내는 것을 말한다. 칩 두께를 줄이면서도 발열량과 성능을 높이는 것이 가능하다. 바꿔 말하면 같은 14나노 미세공정으로 만들어진 칩이라고 하더라도 FOWLP를 적용한 것과 그렇지 않은 스마트폰은 성능과 두께에 있어서 차이를 보일 수 있다.
최 박사는 “수동소자가 아닌 액티브(능동)소자에서 FOWLP를 구현하기가 쉽지 않은데 TSMC는 후공정의 중요성을 알아보고 적극적인 투자를 했다”며 “올해 초까지만 하더라도 수율이 50%가 되지 않았는데 가을에는 90% 넘었다는 이야기가 나올 정도”라고 설명했다.
현재 애플리케이션프로세서(AP)에 FOWLP를 적용하고 있는 업체는 TSMC뿐이다. 삼성전자는 삼성전기와 함께 팬아웃패널레벨패키지(FOPLP)를 R&D하고 있으며 2640억원을 들여 투자를 진행하고 있다.
참고로 FOPLP는 FOWLP의 일종으로 보다 얇은 패키지를 구현하면서도 밀도를 높이는 것이 가능하다. 사각형의 지지기판 위에 칩을 올리기 때문에 낭비되는 부분이 적다. 원형 지지기판이 85%만 사용할 수 있다면, 사각형 지지기판은 95% 활용이 가능하다.
최 박사는 “TSMC는 경쟁사의 특허를 피하기 위해 페이스-다운(Face-down)이 아닌 페이스-업(Face-up)을 이용했다. 삼성도 같은 방식(페이스-업)을 이용할 것으로 보이는데 어떻게 차별화할지가 관건”이라며 “FOWLP는 결코 저렴한 기술이 아니다. TSMC는 가야할 길이라면 자금을 신경 쓰지 않기 때문이며 늦었지만 우리나라도 후공정에 집중해야 한다”고 덧붙였다.
<이수환 기자>shulee@ddaily.co.kr
이 기사와 관련된 기사

당신이 좋아할 만한 뉴스
많이 본 기사
연재기사
실시간 추천 뉴스
-
[이음5G 현황下] 확산 한계치 도달?...“DX본격화 되면, 수요 급증” 전망도
2025-04-04 19:46:29 -
법원, 방통위의 KBS 신임감사 집행정지 신청 ‘기각’
2025-04-04 19:41:00 -
엔시티 위시, 엠넷플러스 '숨바꼭질' 두번째 플레이어로 출격
2025-04-04 17:44:41 -
[DD퇴근길] 윤석열 대통령 파면…ICT·산업계 미칠 영향은?
2025-04-04 17:16:48 -
[윤석열 파면] '탄핵 기념 정식' 인증샷 급증…中 포털서는 실시간 검색어 1위도
2025-04-04 16:49:16


























